车规芯片烧结银中国加压烧结银膏有压烧结银
1/6
- ¥89000.00
- 2025-03-24 05:33:17
- 金属类
- 高可靠加压烧结银,三代半加压烧结银,车规..
- 刘志 13611616628
- 善仁(浙江)新材料科技有限公司
信息介绍
详细参数
而在电动车辆中,电力电子器件节省空间、重量轻、并且即使在恶劣的条件下也要工作可靠。为了满足这些要求,传统基于模块的封装方式已经不能适应下游市场发展的需要,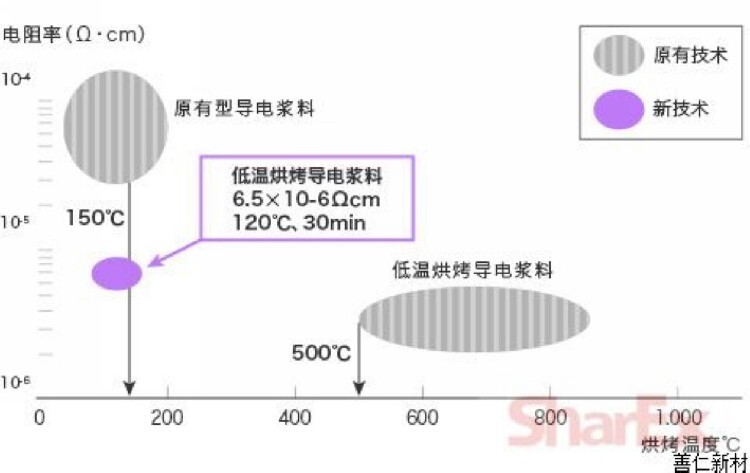
烧结层厚度较焊接层厚度薄60-70%,热传导率提升5倍,国内外诸多厂商把银烧结技术作为第三代半导体封装的核心技术,银烧结技术成为芯片与基板之间连接的选择.
同时在此基础上开发出双面银烧结技术,将银带烧结在芯片正面代替了铝线,或取消底板将基板直接烧结在散热器上,大大简化了模块封装的结构。
- 高可靠加压烧结银,三代半加压烧结银,车规..
- 导电银胶
- 刘志
- 金属类
善仁(浙江)新材料科技有限公司为你提供的“车规芯片烧结银中国加压烧结银膏有压烧结银”详细介绍