烧结银车规芯片烧结银高可靠有压烧结银
1/6
- ¥98000.00
- 2025-02-12 06:24:56
- 电子元件
- 有压烧结银AS9385,高剪切强度烧结银膏,高..
- 刘志 13611616628
- 善仁(浙江)新材料科技有限公司
信息介绍
详细参数
经过第三方的测试,善仁新材新推出的有压烧结银AS9385的剪切强度达到93.277MPa,剪切强度大大超过目前市面上主流的有压烧结银的剪切强度,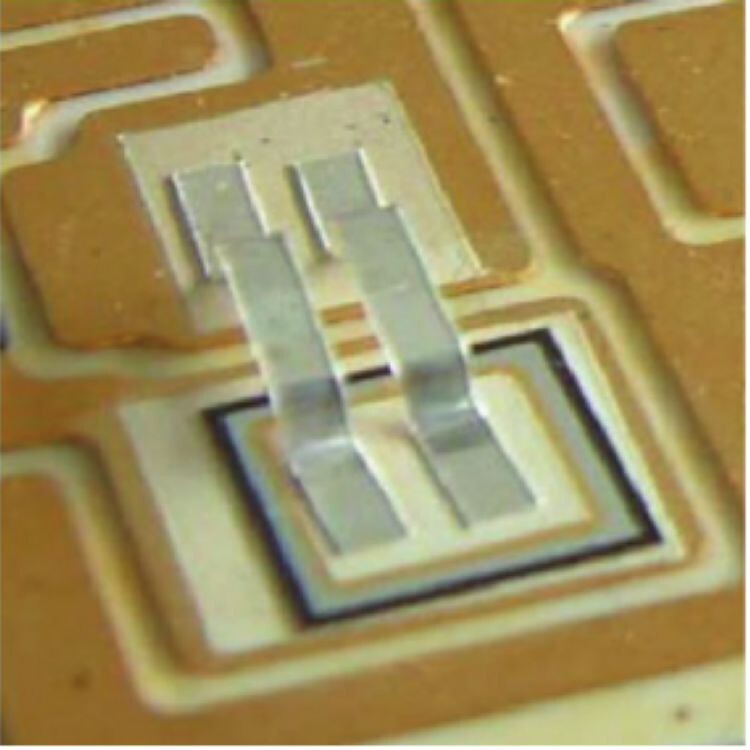
现有的基板铜层的贵金属镀层也增加了成本;散热新材开发的 AS9385有压纳米烧结银可以焊接裸铜,大大降低了客户的生产成本;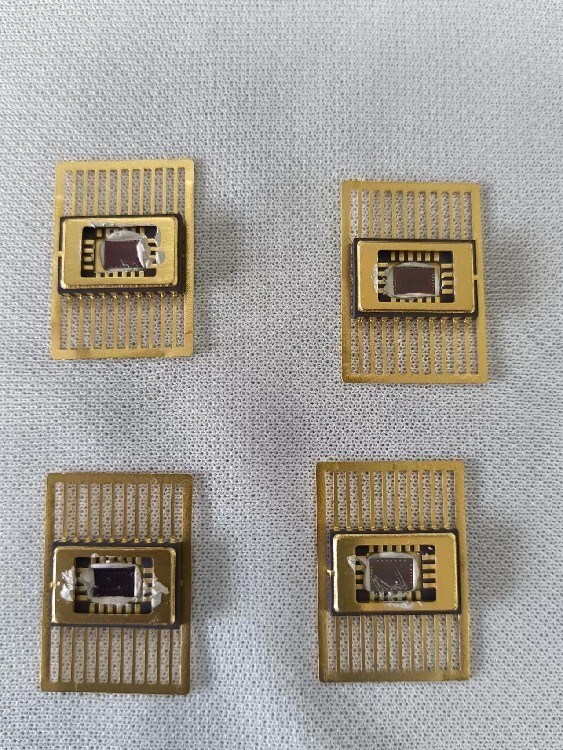
现有的银烧结预热、烧结整个过程长达60分钟以上,生产效率较低;加压烧结银AS9385整个烧结过程可以缩短到20分钟。
现有的银烧结技术得到的连接层,其内部空洞一般在微米或者亚微米级别,善仁新材的烧结银无论是有压烧结银还是无压烧结银都没有空洞。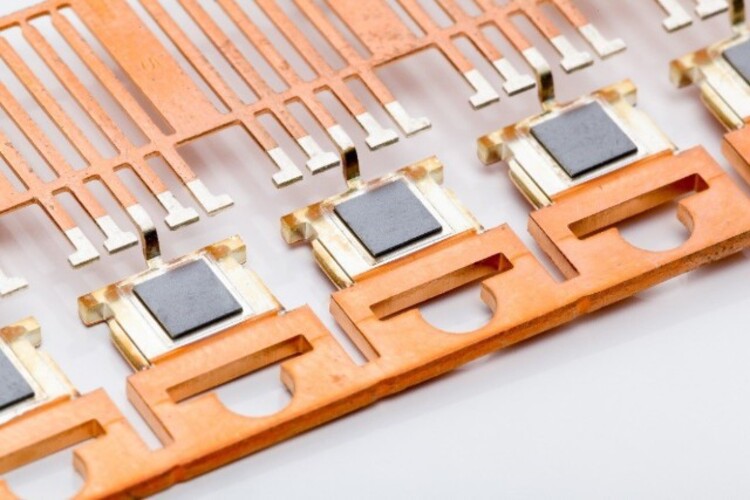
随着第三代半导体器件(如碳化硅和氮化镓等)越来越多的应用在更加高温、高压和高频的环境,相应的封装材料和结构,尤其是芯片-基板的互连,在导热、导电和可靠性方面提出了更为严苛的要求。
相比于传统的焊锡合金和导电银胶等互连材料,善仁新材的有压低温烧结银焊膏AS9385的电导率和热导率可提升3倍,可靠性可提升5倍,并且烧结银熔点为961 ℃,理论上可以在<700 ℃的高温环境下可靠工作,可以满足高温、高功率密度的可靠封装应用需求,得到了越来越广泛的研究和应用。
- 有压烧结银AS9385,高剪切强度烧结银膏,高..
- 导电银胶
- 刘志
- 电子元件
善仁(浙江)新材料科技有限公司为你提供的“烧结银车规芯片烧结银高可靠有压烧结银”详细介绍