烧结银芯片顶部烧结银美国烧结银替代
1/6
- ¥1300.00
- 2024-09-16 03:02:20
- 金属类
- 大面积烧结银,上海烧结银,浙江烧结银,国..
- 刘志 13611616628
- 善仁(浙江)新材料科技有限公司
信息介绍
详细参数
大面积无压烧结银的主要成分:纳米银粉、有机载体等,可以栽无压的条件下焊接10mm*10mm的大芯片,也可以焊接更大面积的芯片。
大面积烧结银的导热系数为: 200W/m·K, (激光闪射法);剪切强度为60 (MPa) 5*5mm (金-金,25℃)。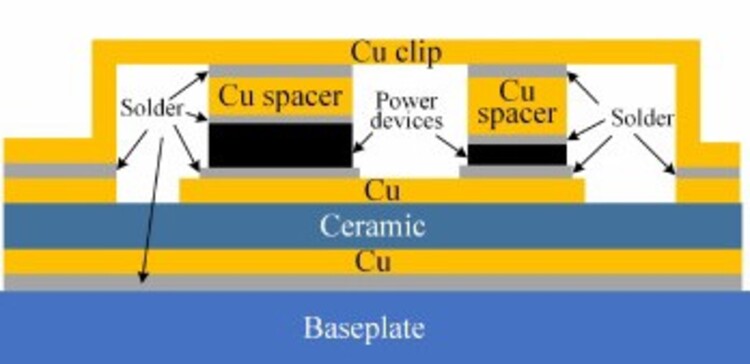
目的是为你们的使用提供可能的建议。但不能取代基于你们本身的目的对该产品所做的操作性和适用性测试。由于我们无法预见各种
终使用条件,SHAREX LTD.不能会对这些信息在客户使用过程中的准确性承担责任。敬请客户使用时,以测量数据为准。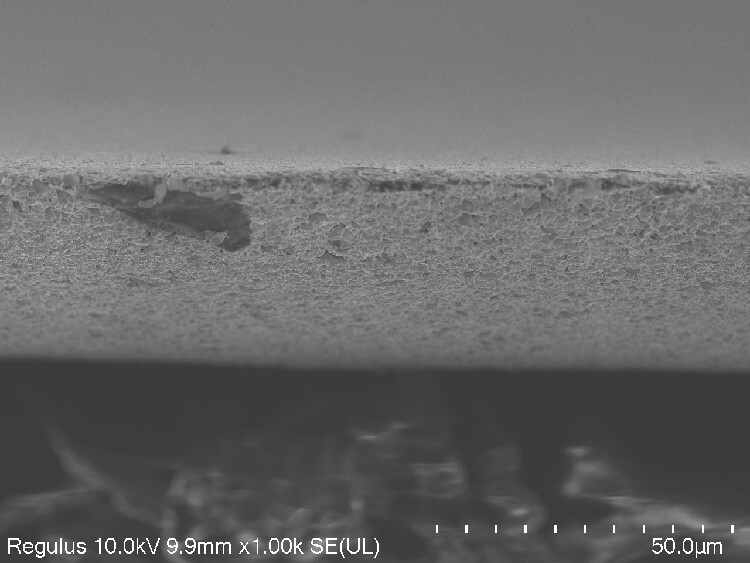
大面积烧结银适用芯片尺寸≦8×8mm;
5. 对于芯片尺寸≦4×4mm,湿胶厚度 50-80μm;芯片尺寸 5×5 ~ 8×8mm,湿胶厚度 90-120μm。
大面积烧结银AS9378的 施工环境和用具、被粘物品等需保持充分干燥;
4. 使用时需佩戴手套,如沾到皮肤上可用肥皂水清洗干净
大面积烧结银AS9378的样本提供的技术参数仅供参考,它们会随不同的工况条件,如设备类型、材质、工艺条件等改变。
使用产品之前,请仔细阅读材料安全资料,产品及产品使用说明:
- 大面积烧结银,上海烧结银,浙江烧结银,国..
- 导电银胶
- 刘志
- 金属类
善仁(浙江)新材料科技有限公司为你提供的“烧结银芯片顶部烧结银美国烧结银替代”详细介绍