石家庄生产SiC碳化硅烧结银膏服务周到
1/6
- ¥1900.00
- 2025-03-30 04:36:46
- 金属类
- SiC碳化硅烧结银膏,宽禁带半导体烧结银,S..
- 刘志 13611616628
- 善仁(浙江)新材料科技有限公司
信息介绍
详细参数
纳米烧结银做为SiC芯片封装的互连层研究总结
IGBT功率器件被广泛用于新能源电车、车载逆变器上,做主要的控制元器件,而以SiC为代表的第三代半导体材料所制成的功率器件能够承受500℃左右甚至更高的温度,比Si小近千倍的导通电阻,多20倍左右的开关频率等性。
善仁新材的纳米烧结银互连层的制作工艺
其工艺主要包括:
① 在覆铜(Cu)基板上涂覆或者丝网印刷纳米烧结银,将芯片放置在纳米银膏上;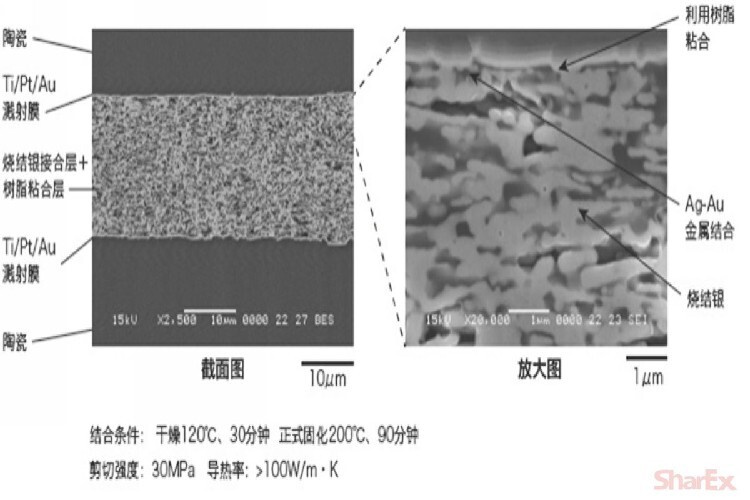
另外,善仁新材研究院发现:较大面积的互连会导致较差的互连质量,其原因是增加的互连面积阻止了有机成分被燃尽,会导致更高的的孔隙率,针对这种现象,善仁新材提出了两个解决方案:
其一为改变芯片尺寸,好控制在5×5 mm2以内;其二是在烧结银中添加“特殊物质”。善仁新材公司通过控制烧结温度、温升速度、烧结时间研究出一种烧结方法,在针对10×10mm2的大面积连接时,既降低了烧结温度,又将烧结后的剪切强度提升至50MPa左右。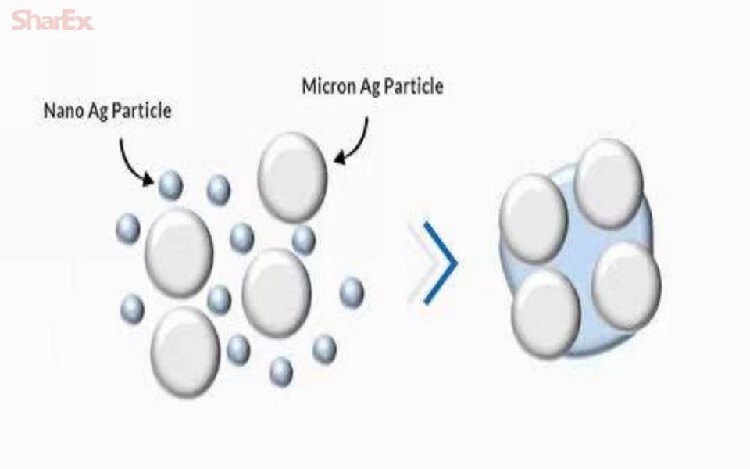
善仁新材另外发现在烧结工艺中引入超声振动能够提高烧结银尺寸和密度,并发现其在处理烧结不充分的边缘地方,能减小过度区,提高纳米烧结银互连层的连接强度;通过引用脉冲电流影响烧结工艺,能够在3分钟的快速烧结中,得到剪切强度为30-35MPa的工艺方法。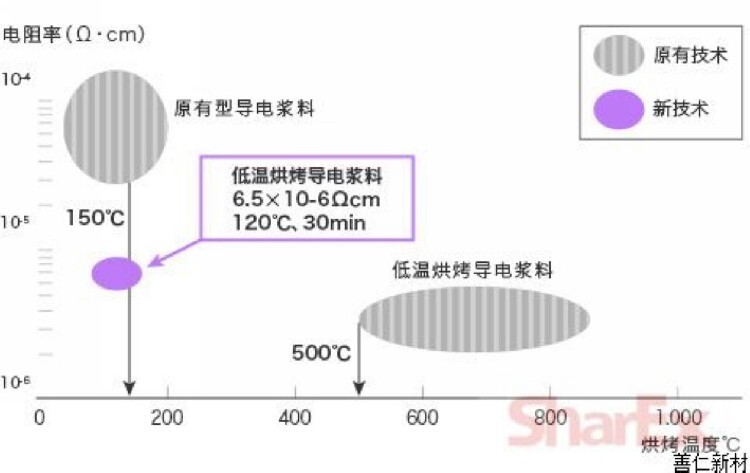
纳米烧结银互连层的孔隙研究
善仁公司统计了在不同时间和温度下孔隙率情况。发现孔隙率的大小和芯片的大小有很大的关系,采用无压纳米烧结银AS9375封装5*5mm的小芯片,几乎无孔隙。对于大于5*5mm的芯片,空隙率会在3-8%之间。孔隙主要由小孔和中孔组成,在250℃烧结时,空隙会很少。
- SiC碳化硅烧结银膏,宽禁带半导体烧结银,S..
- 导电银胶
- 刘志
- 金属类
善仁(浙江)新材料科技有限公司为你提供的“石家庄生产SiC碳化硅烧结银膏服务周到”详细介绍