低温银膏耐温500度银膏上海烧结银
1/6
- ¥1500.00
- 2024-09-16 09:46:07
- 电子元件
- 低温烧结纳米银膏AS9375,进口烧结银替代,..
- 刘志 13611616628
- 善仁(浙江)新材料科技有限公司
信息介绍
详细参数
剪切强度大(剪切强度大于80MPA(2*2镀金芯片));
4.操作简单(无需加压,普通烘箱即可烧结);
三、无压烧结银的应用
1.功率半导体应用
烧结银技术功率测试板块一旦通过了高温循环测试,就可以至少提高五倍的寿命,实现从芯片到散热器的封装连接。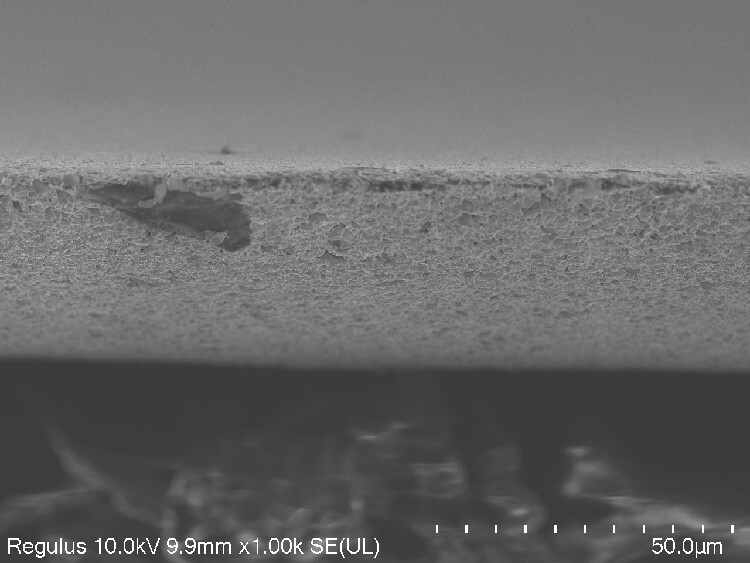
低温无压烧结银对镀层的四点要求
对于AMB基板、DBC基板以及底板来说,铜或铝表面在空气中会发生氧化,形成的氧化物薄膜会阻碍与低温烧结银之间的原子扩散和金属键的形成,降低连接强度。为避免基板表面的氧化,提升与互连材料之间的连接强度,需要对基板进行金属镀层处理。AS9376低温无压烧结银对镀层要求有以下四点
1、扩散层稳定
AMB基板、DBC基板以及散热器表面的金属镀层通常具有基板与互连材料之间的热导通、机械连接和电气连接这三个功能。
润湿性好
随着第三代半导体器件向高温、大功率方向的发展,AMB基板、DBC基板以及散热器表面的金属镀层需要满足高结温可靠性的要求。
3、电阻和热阻尽量低
无压烧结银AS9376导电和导热性能需要具有尽量低的界面电阻和界面热阻,来良好的导电和导热性能;
- 低温烧结纳米银膏AS9375,进口烧结银替代,..
- 导电银胶
- 刘志
- 电子元件
善仁(浙江)新材料科技有限公司为你提供的“低温银膏耐温500度银膏上海烧结银”详细介绍