来源:善仁(浙江)新材料科技有限公司 时间:2025-03-16 21:49:39 [举报]
传统的芯片粘接和基板粘接材料通常由焊料合金组成,其粘结层厚度范围为50至100μm(用于芯片连接)和100至150μm(用于基板连接)。尽管性能还不错,但在特斯拉、比亚迪和现代等主要汽车原始设备制造商的推动下,人们对无压烧结银的偏好越来越高。
与传统的焊料合金相比,烧结银AS9378具有更高的导热性(200至300W/mK),有可能将从结到外壳的热阻降低40%以上,同时显着提高熔点并降低电阻率。此外根据下表数据可观察到银烧结的高使用温度接近900℃远超传统焊料。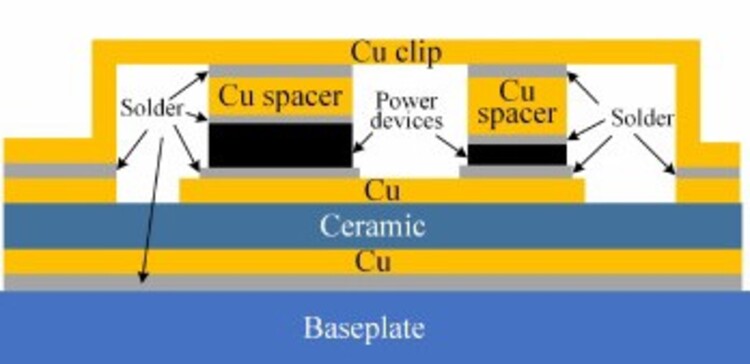
当下的芯片热流密度的增大和模块集成度的进一步提升,现有的小面积接合技术已经不能满足其散热需求。因此,若能使用善仁新材的烧结银实现更大面积的封装互连,则将地提升SiC功率模块的散热性能和高温可靠性。
实现低温烧结银进行大面积封装的可靠互连,促进电力电子半导体器件的高温可靠应用是电力电子器件发展的必然趋势。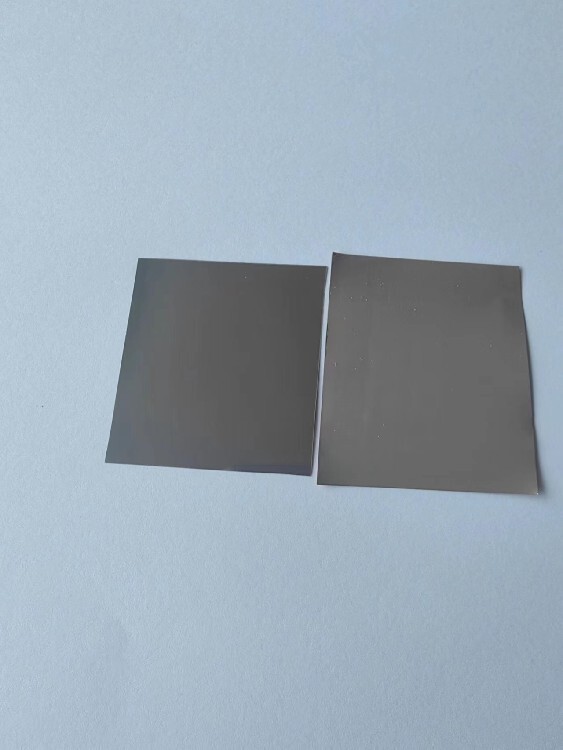
裸芯片封装:善仁烧结银膏(AS9300系列)中的半烧结银(9330)、银玻璃胶粘剂(9355)、无压烧结银(9375)和有压烧结银(9385、9395)用于裸芯片封装,确保电子元件的稳定性和可靠性。
大功率LED封装:善仁烧结银浆(AS9300系列)中的烧结银浆(AS9331、AS9332)用于高功率LED的封装,提高LED的发光效率和寿命。
标签:碳化硅烧结银,深紫外烧结银,大功率LED烧结银,碳化硅单管烧结银