关键词 |
金刚石烧结银,大功率LED烧结银,碳化硅烧结银,碳化硅贴片烧结银 |
面向地区 |
全国 |
粘合材料类型 |
电子元件 |
当前功率半导体行业正在面临SiC和GaN等宽禁带半导体强势崛起,随着电动汽车市场的增量放大,消费者对汽车的高续航、超快充等要求越来越高,电力电子模块的功率密度、工作温度及可靠性的要求也在越来越复杂,封装成了提升可靠性和性能的关键。封装是承载器件的载体,也是SiC芯片可靠性、充分发挥性能的关键。
传统的芯片粘接和基板粘接材料通常由焊料合金组成,其粘结层厚度范围为50至100μm(用于芯片连接)和100至150μm(用于基板连接)。尽管性能还不错,但在特斯拉、比亚迪和现代等主要汽车原始设备制造商的推动下,人们对无压烧结银的偏好越来越高。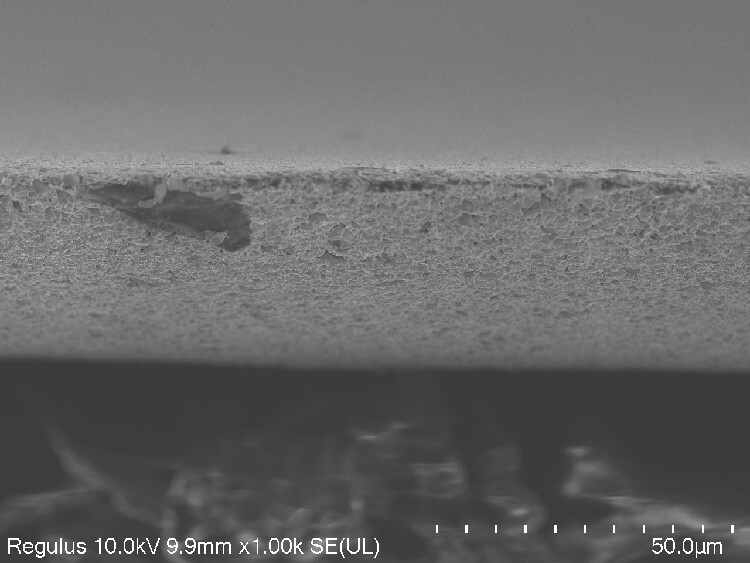
在功率器件中,流经焊接处的热量非常高,因此需要更加注意芯片与框架连接处的热性能及其处理高温而不降低性能的能力。善仁新材的烧结银的热阻要比焊料低得多,因而使用烧结银代替焊料能提高RθJC,而且由于银的熔点较高,整个设计的热裕度也提高了。

全国烧结银分类和应用热销信息